出展者の見どころ:

出展者特集記事
TOPPANグループは、TOPPANホールディングス株式会社を持株会社とし、「印刷テクノロジー」を基盤とする様々な事業会社で構成され、本nano tech 2025では、4つのカテゴリー「健康・ライフサイエンス」 「都市空間・モビリティ」「エネルギー・食料資源」「エレクトロニクス・微細加工」の先端技術を紹介する。微細加工における目玉展示には、最先端2nm EUVフォトマスク、微細な構造体の一括成型を可能とするナノインプリントモールドがある。これらは、グループ内のテクセンドフォトマスク株式会社(以下、テクセンドフォトマスク)の製品である。
1.半導体製造の鍵となる技術の高度化を目指すテクセンドフォトマスク
1900年に、凸版印刷合資会社として設立されたTOPPANは早くから、印刷技術を核として磨き上げた独自の「印刷テクノロジー」を展開して業容の拡大を図ってきた。1960年には、トランジスタ製造用マスクや、ブラウン管用シャドウマスクなどの製造設備を導入し、翌年トランジスタ製造用フォトマスクの試作に成功して、半導体業界にフォトマスクを供給してきた。2005年にはデュポンフォトマスクの全株式を取得して業容を広げた。半導体微細化の面では、2010年に、22および20nm半導体向けフォトマスクの製造プロセスを構築した。2022年には、フォトマスク事業部門を独立させ株式会社トッパンフォトマスクを設立し、2024年11月、テクセンドフォトマスク株式会社に社名変更した。
「テクセンド(Tekscend)」は「テクノロジー(technology)」と「アセンド(ascend:上昇する)」を組み合わせ、さらにtechnologyの“ch”を「鍵(key)」の “k”に置き換えた造語という。その心は、半導体製造におけるキーテクノロジーであるフォトマスクを外販するリーディングカンパニーとして、技術力をさらに高め、半導体業界の最前線で成長を続けるという意思の表出である。
半導体は産業の米と言われ、あらゆる装置、機器は半導体によって制御される。またスマホを始め、情報機器は半導体によって機能することから社会生活の米でもある。経済安全保障の一重要要素とされ、日本政府は近年、半導体産業の再興に向け、多大な支援を行うようになった。
半導体技術の進化を支える重要な要素の一つは回路線幅の微細化である。フォトマスクを通しての露光と半導体基板加工で形成されるLSIチップ上のトランジスタの集積密度は18~24カ月で2倍になってきた。今後もこの傾向が続き、そのためにどんな技術を開発するか国際的組織で議論され、ロードマップに落とし込まれている(図1)。
テクノロジー世代の進化に伴い、回路線幅は縮小してきた。最小線幅を決定する解像限界は露光波長に比例するため、世代が進むにつれて光源は短波長化し、解像性能を向上させている。その結果、2010年代後半以降では、波長193nmのDUV(深紫外線)に代わり、波長13.5nmのEUV(極端紫外線)が採用され、10nm未満のテクノロジーノードを実現する最先端の半導体製造技術が確立された。
nano tech 2025では、1月29日に「ナノテクノロジーが最先端半導体を先導する」と題した特別シンポジウムを企画し、10時30分からの3番目に、テクセンドフォトマスク 小嶋洋介氏による「EUV用フォトマスクの最近の進歩と将来展望」と題した講演が予定されている。
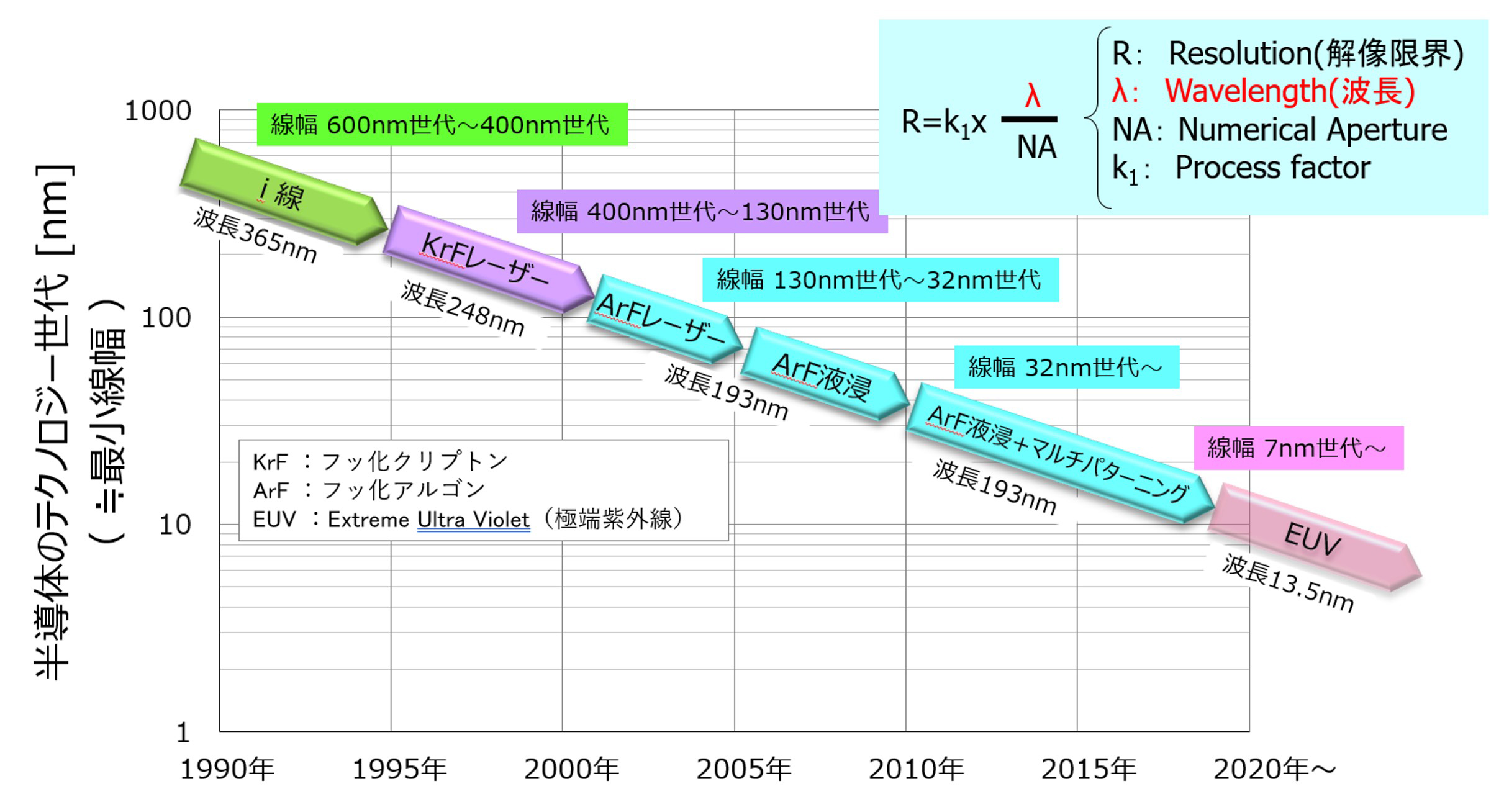
図1 : 半導体の開発ロードマップ(IRDSをもとにテクセンドフォトマスク作成)
2. 最先端2nmプロセス用EUVフォトマスク
EUV露光は、21世紀初頭より次世代技術と期待され、テクセンドフォトマスクは20年を超える技術開発のもと、2nmプロセス用EUVフォトマスクの実用化に取り組んでいる(図2)。
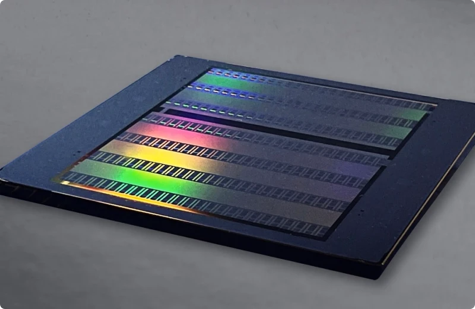
図2:EUVフォトマスク
EUV光はガラスレンズによる光の屈折現象のため集光が出来ないので、従来のDUV光で用いられてきた透過型の集光系に代わり、露光機およびフォトマスクは全て反射光学系で構成される(図3)。従来の透過型フォトマスクが、基板上にペリクル(マスク表面保護膜)、遮光膜(吸収層)を設けただけなのに、EUVの反射型フォトマスクは多層反射膜に加えて、その保護膜、遮光膜上に低反射膜、基板裏面コーティングまで設けた多層構造となる。この構造の設計、各層の材料・膜厚選定、多層反射膜の膜厚・層数制御、それらの組み合わせなど、20年余りにわたり幾重にも考察、試行錯誤して、現在の形に到達した。
テクセンドフォトマスクは、2nmノード以細の半導体量産に向けたソリューションの提供を目指し、次世代半導体向けの高NA EUVを含む、EUVリソグラフィを使用した2nmロジック半導体プロセスノード対応のフォトマスクに関する共同研究開発契約を、IBMと2024年2月に締結した(契約当時の社名はトッパンフォトマスク)。
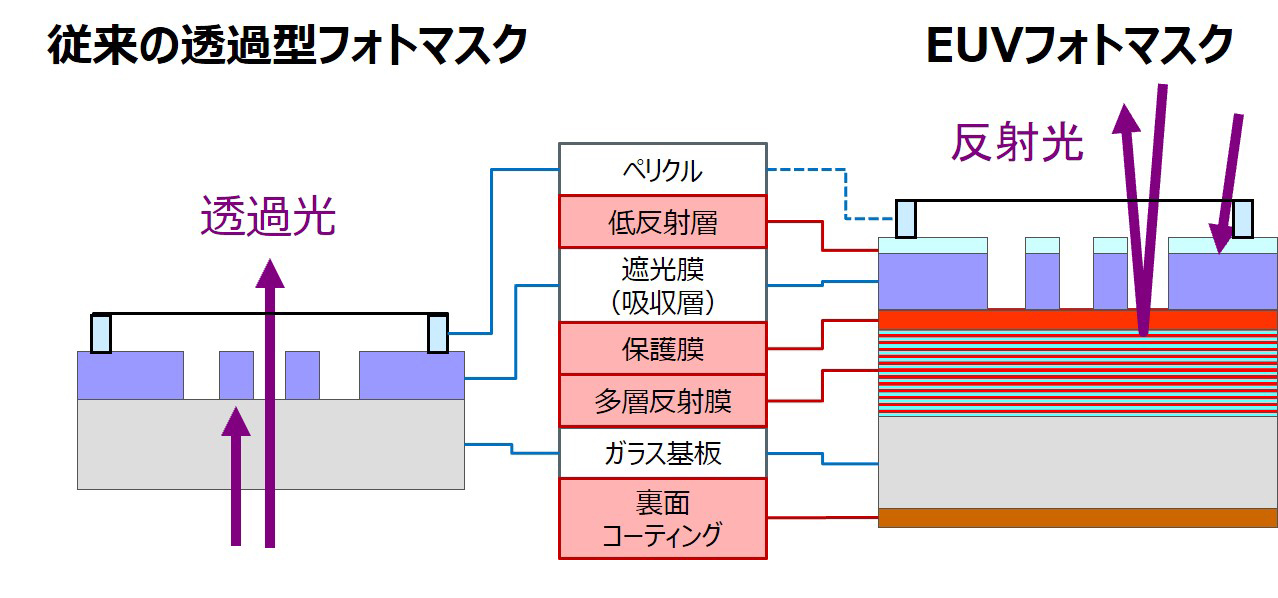
図3:透過型フォトマスクとEUVフォトマスの構造の違い
3. 微細構造体の一括成型を可能とするナノインプリントモールド
フォトリソグラフィ(紫外線とフォトマスクを使った微細加工)により、最先端の微細加工開発を進めることはできるが、その工程は複雑である。そこで、原版となるモールド(金型)を型押しすることで、数nm単位のパターンを転写するナノインプリントが考案され、微細構造体を安価に再現性良く大量に製造する技術として期待されている。テクセンドフォトマスクは、半導体用フォトマスク事業を通じて培ったリソグラフィ技術を応用し、高精度なナノインプリント用モールドを開発、製造する。 モールド基板には、石英またはシリコンを使用する(図4)。フォトマスクと同等の高品質な石英材料を使用する石英モールド(サイズ:152mm角)は、安定性・平坦性に優れ、高解像度パターン、多段構造を形成できる。シリコンモールド(サイズ:直径200mm)は、電子ビーム描画、ドライエッチングによる深掘り加工などの半導体加工技術を活用し、高精度で、アスペクト比の高いパターンや階段状、複雑な3次元(3D)形状のモールドを製造できる。複数のモールドを用いることなく、3D構造を一括して転写できることが、ナノインプリントモールドの特徴の一つである。
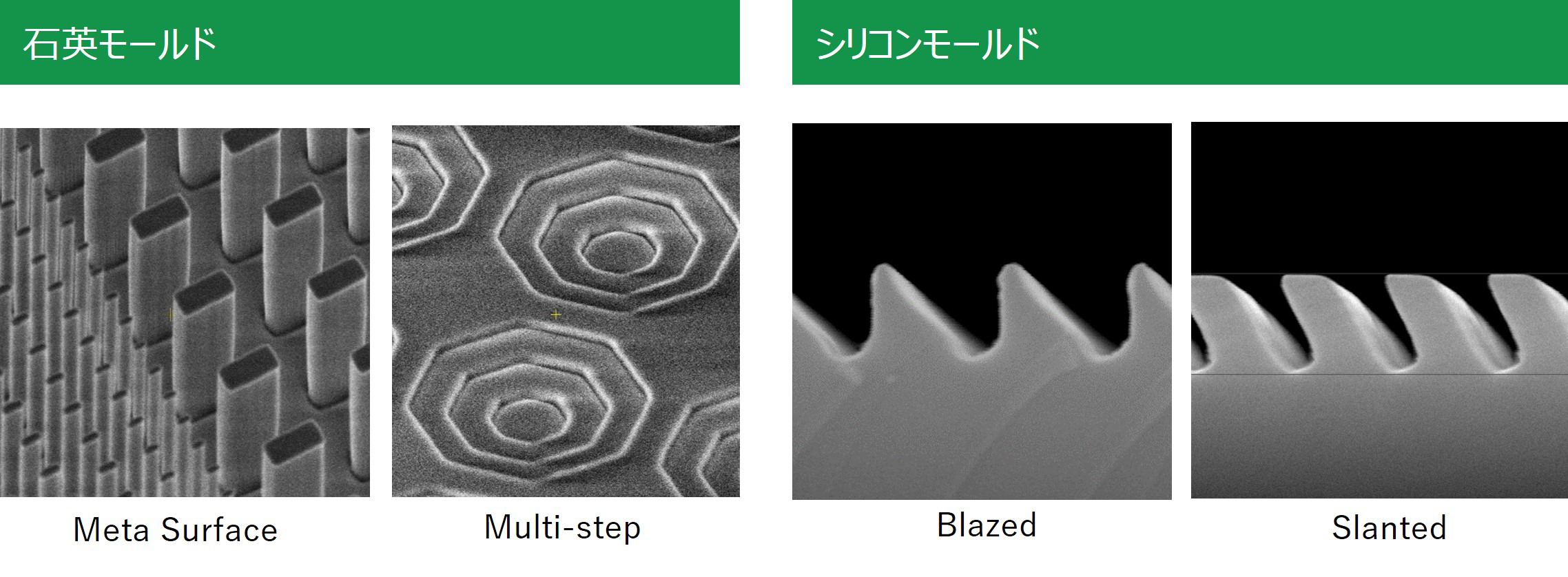
図4 : ナノインプリントモールドの形状パターン例
ナノインプリントに期待されるアプリケーションを図5に示した。広範囲のサイズおよび精細度のパターン形成に応用が期待される。テクセンドフォトマスクは、来場者からのナノインプリントモールド応用の提案を期待している。
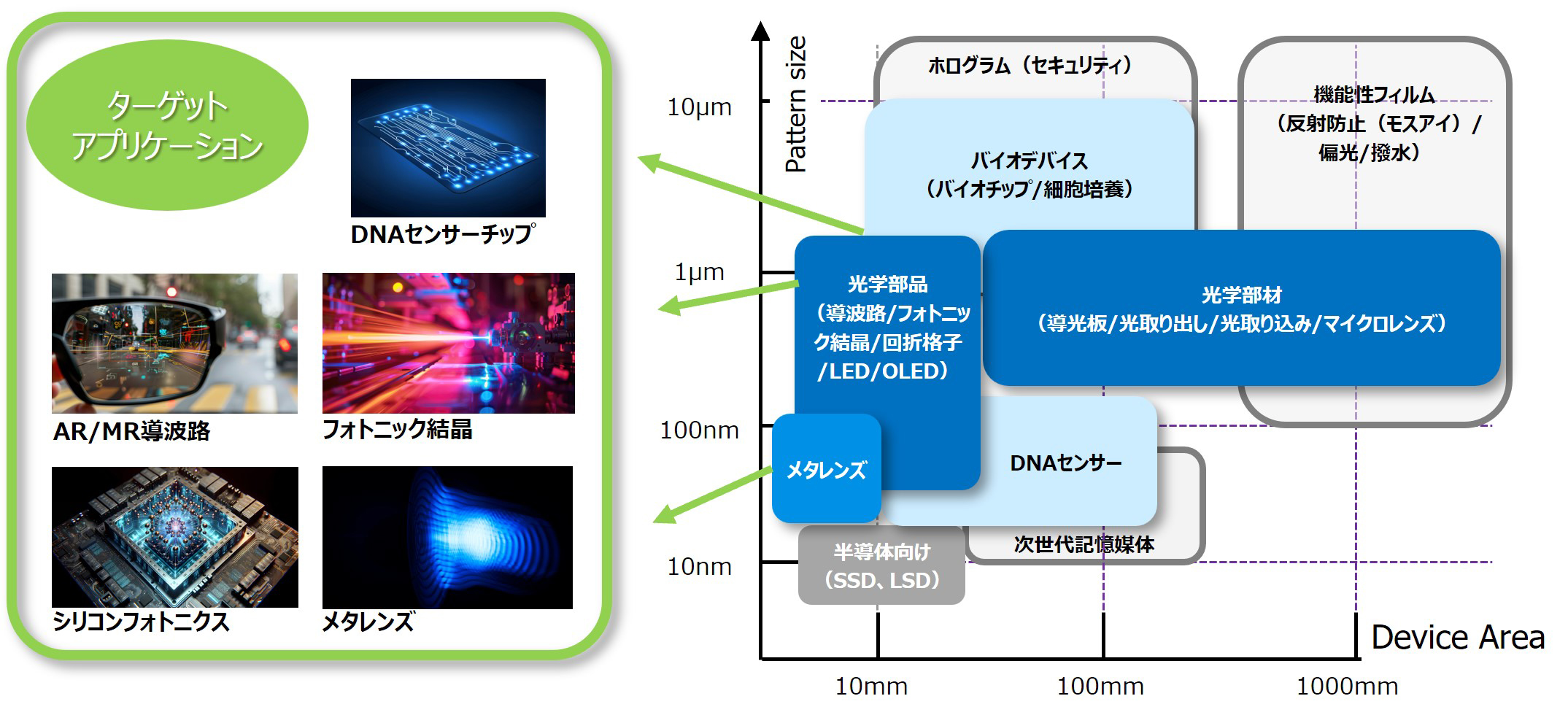
図5 : ナノインプリントのアプリケーションマップ
(注)図はテクセンドフォトマスクから提供された。
小間番号 : 4B-10
出展ゾーン : 応用:ナノイノベーションゾーン
Copyright© 2025 JTB
Communication Design, Inc. All
rights reserved.

